-

-
熱變形外貌檢測儀

- 品牌:美國Akrometrix
- 型號: AXP
- 產地:美洲 美國
- 供應商報價:面議
-
香港電子器材有限公司
 更新時間:2025-07-25 11:10:27
更新時間:2025-07-25 11:10:27 -
銷售范圍售全國
入駐年限第10年
營業執照已審核
- 同類產品熱變形外貌檢測儀(1件)

立即掃碼咨詢
聯系方式:021-63813293
聯系我們時請說明在儀器網(m.oupniq.cn)上看到的!
掃 碼 分 享 -
為您推薦
產品特點
- Shadow Moiré 是一種非接觸式,全視野的光學技術,它用樣品上的參考光柵和它的影子之間的幾何干擾產生摩爾云紋分布圖(Moiré Pattern),進而計算出各像素位置中的相對垂直位移。它需要一個倫奇刻劃光柵(Ronchi-ruled grating),一條大約45度角的光源和一個垂直于光柵的相機。
詳細介紹
產品簡介:
NEW !!
Table Top Shadow Moiré (TTSM)
For fat, room temperature warpage metrology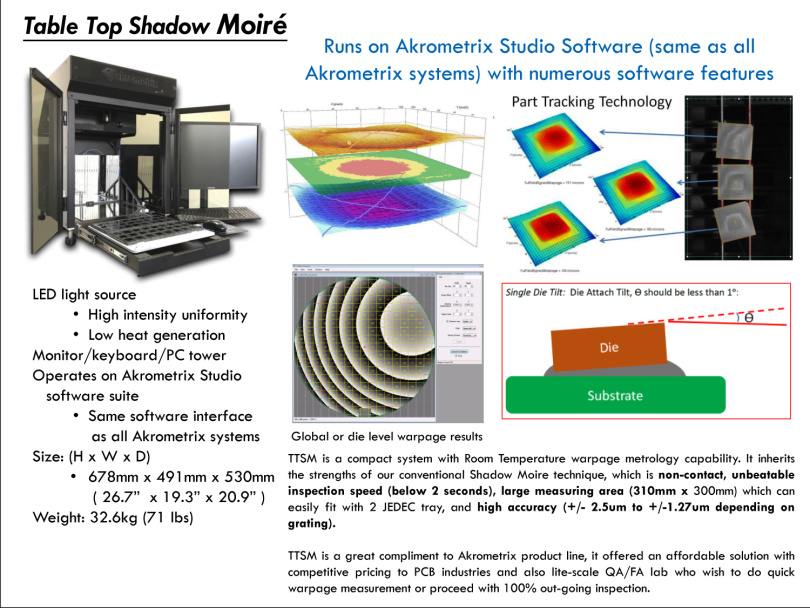
Shadow Moiré 技術 Shadow Moiré 是一種非接觸式,全視野的光學技術,它用樣品上的參考光柵和它的影子之間的幾何干擾產生摩爾云紋分布圖(Moiré Pattern),進而計算出各像素位置中的相對垂直位移。它需要一個倫奇刻劃光柵(Ronchi-ruled grating),一條大約45度角的光源和一個垂直于光柵的相機。 Shadow Moiré的Phase stepping技術來增加測量分辨率,右圖中示出其光學集成的圖像與加熱腔室。

新一代表面測量和分析技術
Akrometrix 的ZGTherMoiré技術是行業領xian的熱變形翹曲分析技術。自一九九八年以來,TherMoiré產品作為翹曲管理解決方案,服務于全 球企業。
TherMoiré技術可以模擬回流焊工藝和操作環境條件、同時捕捉一個完整的歷史翹曲位移表現。運用這一重要的信息,獲得元器件/基板翹曲度的一致性來直接影響一級和二級裝配產量和提高產品的可靠性。
可應用于研發/診斷/生產監控,測試結果符合國際標準(JEDEC, JEITA等),測試精度為微米級,極大的滿足了高端客戶對翹曲測試監控的要求,是國際主流并被JEDEC, JEITA等標準推薦的測試方法,主要的參數有 Coplanarity, JEITA ED7306 (Normalized Diagonals Signed Warpage), JEDEC 22B112 (Full Field Signed Warpage), IPC TM-650(Twist & Bow), IPC 9641 (BGA vs PCB Gap Analysis), CTE 等。
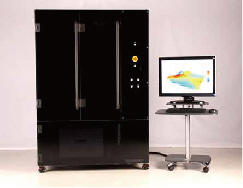
TherMoiré AXP 產品特性
zui大樣品尺寸: 400mm x 400mm
zui小樣品尺寸: 0.5mm x 0.5mm (如配備DFP功能時)
在2秒內獲得140萬個數據點
zui高每秒加熱1.5oC攝氏度
紅外線加熱和對流冷卻來控制溫度
高分辨率測量小型樣品
XY 軸應變STRAIN和熱膨脹系數CTE 計算
運用QL冷卻系統提高實驗能力
支持從室溫到300oC以下的回流爐溫度模擬,以及-50oC至300oC度可靠性測試選項
軟件成熟,可獨立PC運行做進一步離線分析
樣品追蹤功能支持多樣品同時測試,提高產量
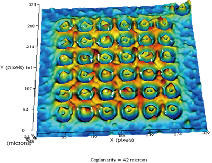
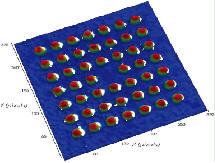

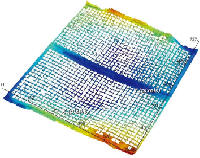
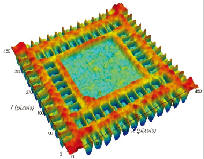
針對細小樣品也能測量熱變形
印刷電路板
插座
QFN (3mm x 3mm)
Akrometrix DFP(Digital Fringe Projection) 解決方案
新的獨立產品提供純對流加熱組裝回流模擬方式!
能有效測量帶臺階的樣品及保留钖球的測量!啟用臺階高度和間斷表面測量
FOV 可以移動到樣品上的任何位置(Gantry fixture)
改進的頂部/底部的溫度均勻性 – 無光柵
應用于錫球的共面性測量,非連續面和插座測量
高錫球的共面性測量X / Y分辨率
zui大 FOV : 48mm x 64mm
zui大樣品尺寸: 300mm x 300mm
zui小樣品尺寸: 5mm x 5mm
Z-軸分辨率 : 5 microns
Z-軸準確性 : 5 microns


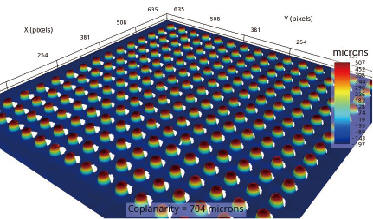
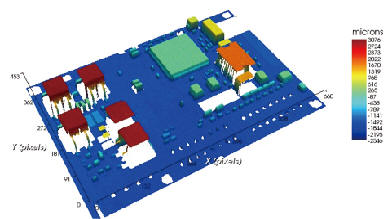
CXP放映機/相機門口Gantry
BGA 高錫球測量
啟用臺階高度和間斷表面測量

FOWLP 的翹曲解決方案 - AKM600P FOWLP
Akrometrix AKM600P是專為FOWLP市場設計的翹曲量測解決方案 利用影子摩爾shadow moiré 技術進行翹曲量測, Z軸分辨率可達1.25μm
可進行晶圓與平板大面積的翹曲量測
全視場FOV成像, 不論晶圓大小都可"單次捕獲"整個晶圓/平板, 捕捉時間少于2秒
測量面積: 600mm x 600mm
采用NIST標準進行標定
如需使用26°C ~ 300°C的熱變形測量, 可選配加熱裝置
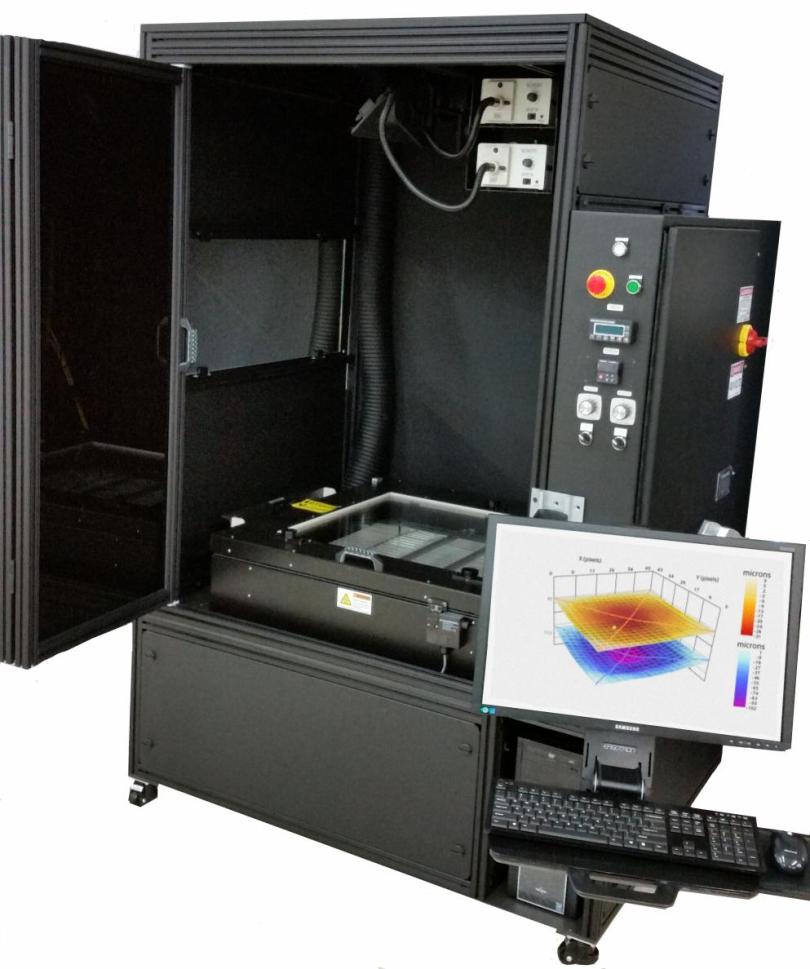
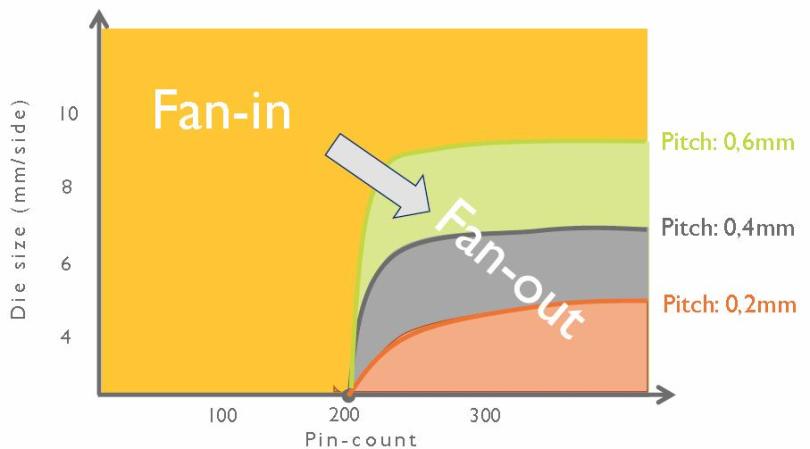
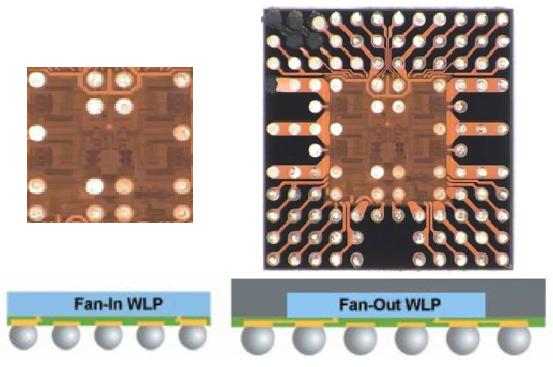

Fan Out Wafer Level Processing (FOWLP)
扇出晶圓加工

Digital Image Correlation - DIC (2.0) 模組
Add-on 模組: AXP & PS200S
Strain和CTE 測量模組
資料獲取時間: < 1 second
In-Plane 應變分辨率: < 1.0 μm
Strain 分辨率: < 150 microstrain (Δ L/L x 10-6)
溫度范圍: 26°C to 300°C
視線范圍: 75 mm x 75 mm

DIC 2.0 模組裝配
在TherMoiré AXP內



Strain measurement can be critical for components, PBCs, and material layers
Mean strain values used
for CTE calculation
Akrometrix Studio 軟件包
Akrometrix Studio 8.2 是一套先進的集成軟件模塊, 提供了一套zui全面的表面表征和分析能力提供一起運作。 當用到 TherMoiré AXP 表面量測系統十, Studio 6.0 可組成一套測量解決方案, 產生快速,全面表征了廣泛的微電子部件和組件的表面信息。
Studio 8.2 使用不同種類的強大圖形和分析功能為用戶得出結論,并作出決定 。
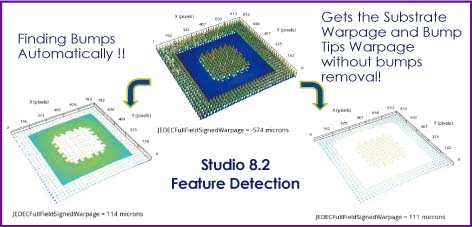


Studio 8.2 Die/Package Tilt
樣品追蹤:自動智能追蹤,實現批量測試功能
Interface Analysis軟件
實時監測回流過程中PCB及元器件變形情況3D圖形分析軟件
* HNP/H0P(頭枕效應)
* 短路
* 斷路
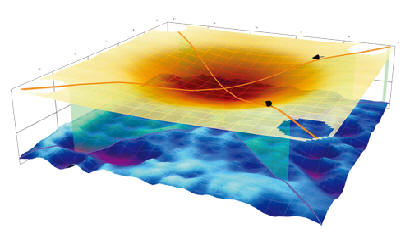

三維圖形分析 -
在回流過程中的組件之間的間隙通過/警告/失敗圖形Pass/Warning/Fail Maps
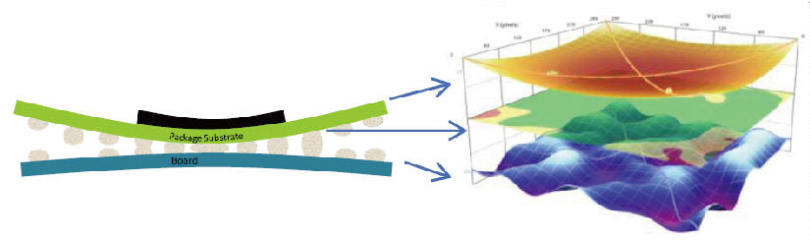
SMT Assembly解決方案
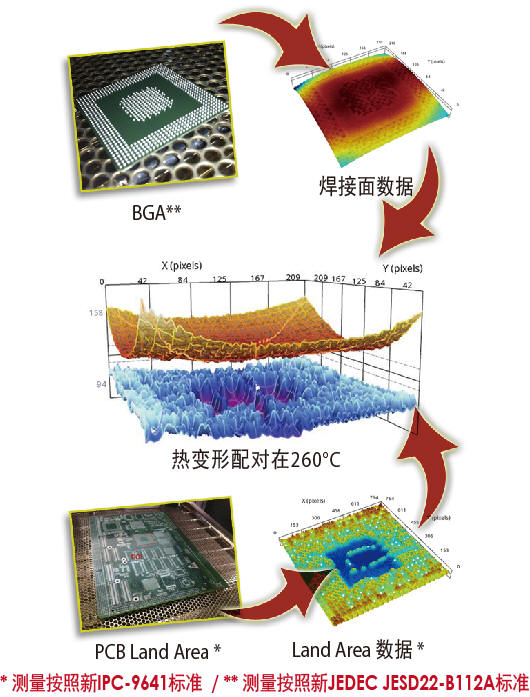
AXP CRE 模組 (Convention Reflow Emulation 模組)
它結合了zui大分辨能力的AXP與測量間斷表面的能力!
對流加熱和冷卻
生產/裝配對流回流爐的溫度均勻一致
亞微米分辨率的功能/多部分測試
zui大 FOV : 70mm 圓形

CRE 模塊的樣品臺

Studio軟件的實時分析功能 (Real-time Analaysis)它結合了高批量的測試 “Go/No Go” 準則! 量測后即時看到“通過/失敗”指標
應用于測量結果時,用戶可自行定制
“合格/不合格”的標準
與樣品跟蹤多個樣品測試一起運作
在室溫下和在熱外貌下工作