
技術指標及功能
廣泛應用于生產線,是6英寸,8英寸等主力I線生產機臺,適用于I線光刻膠的曝光,操作簡單,曝光精度準,解析力zui高可達0.35UM (350NM)

報價:面議
已咨詢5877次日本Nikon 步進光刻機
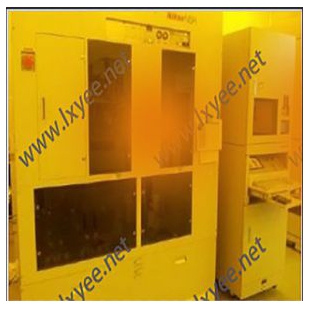
報價:面議
已咨詢2825次日本Nikon 步進光刻機

報價:面議
已咨詢1466次日本Nikon 步進光刻機
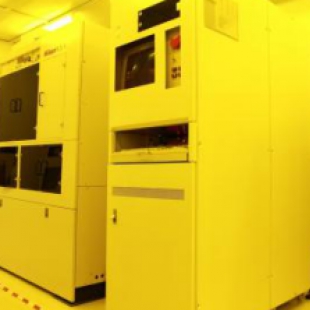
報價:面議
已咨詢3813次日本Nikon 步進光刻機
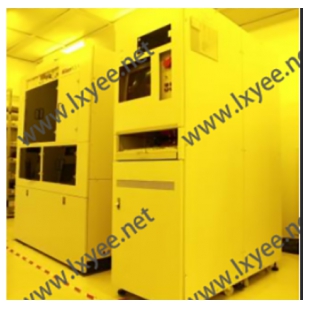
報價:面議
已咨詢789次日本Nikon 步進光刻機

報價:面議
已咨詢852次日本Nikon 步進光刻機
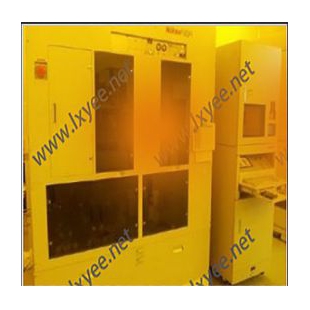
報價:面議
已咨詢656次日本Nikon 步進光刻機

報價:面議
已咨詢1108次日本Nikon 步進光刻機

ASML 光刻機 Twinscan NXT:1980Di

Syskey 緊湊式濺射系統 Compact Sputter,靈活的基板尺寸,最大可達6英寸,基板架加熱溫度最高可達500℃,出色的薄膜均勻性,誤差小于±3%, 最多可配備5個6英寸磁控濺射源(可選配3或4個),支持射頻、直流或脈沖直流電源,最多可支持3條氣體管路,支持順序沉積和共沉積。

Syskey 緊湊式熱蒸發系統 Compact Thermal ,靈活的基板尺寸,最大可達6英寸, 基板架加熱溫度最高可達500℃,出色的薄膜均勻性,誤差小于±3%,可選配電子束或熱舟蒸發源(最多3個),速率控制沉積,可沉積多層薄膜,選用特定目標材料

高真空濺射系統 HV Sputter,靈活的基板尺寸,最大可達12英寸或200×200毫米, 基板架加熱溫度最高可達800℃,出色的薄膜均勻性,誤差小于±3%

超高真空磁控濺射鍍膜機 UHV Sputter,? 基板支架加熱至 800 °C ? 優異的薄膜均勻性小于 ±3% ? 磁控濺射源(數量最多 8 個),可選強磁版本

Syskey 高真空熱蒸發鍍膜機HV Thermal 高真空熱蒸發系統可提供的真空環境 用于常見薄膜沉積,包括金屬、有機物、鈣鈦礦和化合物。全自動系統可滿足各種應用要求,包括OLED、OPV、OPD等。

Syskey 超高真空熱蒸發鍍膜機UHV Thermal, ? 靈活的基板尺寸可達 8 英寸? 基板支架加熱至 800 °C? 優異的薄膜均勻性小于 ±3%? 船和電池源(數量最多 6 個)? 可以共蒸發和摻雜。? 用選定的目標材料沉積多層薄膜? 可與其他沉積系統集成

Syskey 高真空電子束鍍膜系統 HV E-beam, 靈活的基板尺寸可達 12 英寸,? 優異的薄膜均勻性小于 ±3%